La possibilité de réaliser des interfaces avec un
confinement de dopants sur quelques couches permet des applications dans la
technologie des détecteurs infrarouges et des transistors à effet de champ [1]. Cependant, la présence de dopants
proches de la surface peut modifier le mode de croissance et les propriétés
électroniques d'une interface. Des études ont déjà montré que la présence du
bore à l’interface métal/Si(111) modifie radicalement la morphologie de la
surface (par exemple l’interface Cu/Si(111)-B [2,3]).
Dans l’étude qui va être présentée, nous avons
observé l’influence de la réactivité d’une surface d-dopée sur la croissance du siliciure
d’erbium. Pour cela, nous avons utilisé un substrat de silicium (111) d-dopé bore, dont la reconstruction de surface
est très différente de la 7x7. En effet, les liaisons pendantes des atomes de
silicium de surface peuvent être passivées par le bore.
La réactivité de la surface peut être contrôlée par la concentration en
bore : elle est d’autant plus
importante que la concentration en bore est faible.
Toutefois la réactivité
d’une telle surface sera toujours inférieure à celle d’un substrat de silicium
(111) reconstruit 7x7.
Nous
présenterons tout d’abord les résultats observés sur un substrat peu dopé et
les comparerons à ceux obtenus dans le chapitre précédent. Nous examinerons
ensuite le cas d’un substrat très dopé.
Les observations STM ont montré des modifications
importantes sur la cristallographie et la croissance des siliciures obtenus.
C’est pourquoi nous avons été amenés, dans le cas d’une surface très dopée, à
étudier plus précisément les propriétés électroniques, la composition et le
mode de croissance de ces siliciures en associant la photoémission UV, la
spectroscopie ISS et la microscopie à effet tunnel.
3.2 LA SURFACE Si(111)-B Ö3xÖ3 R30°
Cette
reconstruction du silicium (111) induite par la présence du bore a été mise en évidence
par des expériences en RHEED (diffraction d'électrons rapides) et en
spectroscopie Auger [4]. Les
premières images STM en résolution atomique de la surface montrèrent un
arrangement périodique Ö3xÖ3 R30° d’adatomes (noté BÖ3 dans la
suite) [5]. L’intérêt pour cette surface
motiva de nombreuses études [6-9]
dans le but d'établir un modèle atomique.
3.2.1) Le
modèle structural de la BÖ3
Les
éléments trivalents de la colonne III (Al, Ga, In) déposés sur Si(111)
induisent, de la même manière que le bore, une reconstruction Ö3xÖ3 R30° [10]. Cependant, ils se placent en position d’adatomes en site T4,
tandis que le bore, plus petit et lui aussi trivalent, se situe en sub-surface.
Il est intéressant de noter que le bore étant également plus petit que le
silicium, les liaisons Si-B sont plus courtes que les liaisons idéales Si-Si.
Sur le
modèle atomique de la figure 3.1,
les atomes de bore sont situés en deuxième couche, en position S5, toutes les Ö3 fois le paramètre de maille. La structure
est, de plus, tournée de 30° par rapport à la 1x1. Les adatomes de silicium
sont placés en site T4 [11] et
possèdent la même périodicité Ö3 que le bore.

Figure 3.1 : Modèle atomique de la
reconstruction BÖ3.
Notons que plusieurs études ont permis d’établir la
configuration atomique responsable de la périodicité Ö3. Diverses configurations étaient
possibles : B-S5, B-T4 et B-H3. E. Kaxiras et al. [12] ont effectué des calculs d’énergie totale en déterminant la densité
d’états locale dans les trois cas. La configuration B-S5 s’est
révélée être plus favorable de 1 eV (par maille BÖ3) par rapport à la position
B-T4 et de 2,1 eV par rapport à la position B-H3.
3.2.2) Les
propriétés électroniques
Le
bore ([He]2s22p) forme 4 liaisons avec ses proches voisins Si et
nécessite un électron supplémentaire pour compléter sa couche de valence.
Celui-ci provient d’un transfert de charges de l’adatome de silicium vers le
bore.
La
photoémission inverse a montré l’existence d’une bande non occupée, associée à
des liaisons pendantes vides sur les adatomes et située à 1,5 eV au dessus du
niveau de Fermi au point ![]() . La photoémission directe a, quant à elle, mis en évidence
la présence de trois états de surface. Parmi ces états, deux ont déjà été
observés sur les systèmes Si(111)-Ö3xÖ3 R30°-Al, Ga, In. Le troisième état de surface n'a pas d'équivalent dans
ces systèmes. Il n’est observé que dans le cas du bore et sa présence est
attribué aux liaisons du bore avec les atomes de silicium environnants [13].
. La photoémission directe a, quant à elle, mis en évidence
la présence de trois états de surface. Parmi ces états, deux ont déjà été
observés sur les systèmes Si(111)-Ö3xÖ3 R30°-Al, Ga, In. Le troisième état de surface n'a pas d'équivalent dans
ces systèmes. Il n’est observé que dans le cas du bore et sa présence est
attribué aux liaisons du bore avec les atomes de silicium environnants [13].
A. B.
McLean et al. ont étudié la structure électronique de cette reconstruction par
spectroscopie des photoélectrons de cœur sur les niveaux Si-2p et B-1s [14]. Ils ont observé une signature de
symétrie s-pz dans le diagramme d’absorption B-1s au dessus du
niveau de Fermi. Elle est associée à une transition électronique du niveau B-1s
vers un état vide de la surface (une des liaisons pendantes des adatomes de
silicium).
Ce
transfert de charge, confirmé expérimentalement et théoriquement, est
responsable de la grande stabilité de cette reconstruction. Tandis que la 7x7 possède 19 liaisons
pendantes, la BÖ3 n’en possède
aucune lorsque la concentration en bore est maximale. La passivation des liaisons
pendantes de la BÖ3 par le bore a pour
résultat d’abaisser l’énergie de surface.
L’image STM de la figure 3.2 montre la reconstruction Ö3xÖ3 R30° et révèle deux types de sites
traduisant la présence ou l’absence de bore.

Figure 3.2 : Image STM de la Si(111)-B-Ö3xÖ3 R30° (13x13 nm2, V = 1,761
V, It = 0,707 nA).
Dans
les conditions de concentration maximale, soit 1/3 de monocouche en bore, aucun
site brillant n’est observé. Un site brillant (signalé par la flèche) est caractéristique
d’une absence d’atome de bore en deuxième couche. Le site S5 est dans ce
cas occupé par un atome de silicium.
Le STM permet
donc de déterminer facilement la fraction de bore présent en surface.
3.2.3) La préparation de la
surface BÖ3 et du dépôt d’erbium
Les
échantillons sont clivés dans des plaquettes de silicium(111) dopé bore, de
résistivité 2.10-3 W.cm. La procédure de
préparation est sensiblement identique à celle de la 7x7. Une fois atteinte la
température de 800°C, la surface subit une série de recuits rapides à 1200°C
pour éliminer les contaminants et réorganiser la surface. On obtient alors une surface peu dopée, donc très réactive.
Une surface très dopée s’obtient
après un recuit supplémentaire d’une dizaine d’heures à 750°C. Dans les deux
cas, de grandes terrasses reconstruites Ö3xÖ3 R30° peuvent alors être observées.
Au
cours de ces traitements thermiques, la ségrégation du bore vers la surface est
activée par exodiffusion [15,16]. Le recuit de dix heures à 750°C correspond
au meilleur compromis pour obtenir une concentration maximale en bore. Les
dopants, tels que le bore, diffusent dans le silicium via des défauts ponctuels
suivant divers mécanismes : interstitiel, alternance substitu-tionnel/interstitiel
et lacunaire.
Notons que la ségrégation des dopants à la surface
étant régie par la réduction de la tension superficielle, elle conduit à un
minimum de l’énergie libre.
Les
dépôts d’erbium sont effectués dans les mêmes conditions que l’interface
Er/Si(111) 7x7 : c’est-à-dire sur un substrat à température ambiante suivi
d’un recuit (dépôt à « froid ») ou sur un substrat maintenu à 500°C
(dépôt « à chaud »), avec un flux d’erbium de 1/3 de monocouche par
minute.
3.3 L’INTERFACE Er/Si(111)-B Ö3xÖ3 R30° PEU DOPE
L’interface Er/Si(111)-B Ö3xÖ3 R30° peu dopé a montré des résultats globalement comparables à ceux obtenus à l’interface Er/Si(111) 7x7. Plus particulièrement, les structures 2D ErSi2 et 3D ErSi1,7 ont été observées à cette interface. Nous les présenterons tout d’abord avant d’exposer les deux singularités observées dans le mode de croissance. Ces singularités concernent la formation de la 2Ö3 et d’une nouvelle structure bidimensionnelle.
3.3.1) La surface BÖ3 peu dopée
L’image
STM de la figure 3.3 présente une
surface BÖ3 peu dopée.

Figure 3.3 : Image STM de la BÖ3 avec une faible concentration
en bore (15x15 nm2, 0,23 monocouche).
La concentration
en bore de 0,23 monocouche a été estimée statistiquement en comptant le nombre
de sites sombres. Ceci correspond à une
diminution de 75% du nombre de liaisons pendantes par rapport à une surface
reconstruite 7x7. Aussi la réactivité de la surface BÖ3 est-elle vraisemblablement plus faible que
celle de la surface 7x7.
3.3.2) Le
mode de croissance et les siliciures 2D et 3D
Le mode de croissance que nous avons observé est sensiblement identique à
celui observé sur l’interface Er/Si (111) 7x7, c’est-à-dire de type couche par couche. Aussi, seules les images en
résolution atomique attestant de la présence du siliciure 2D ErSi2
et du siliciure 3D ErSi1,7 sont présentées sur la figure 3.4.


(a) (b)
Figure 3.4 : (a) Résolution atomique 1x1
du siliciure B-ErSi2 (2x2,5
nm2, It = 0,775 nA,V = -0.176 V),
(b) Ö3xÖ3 R30° du siliciure 3D (3,6x3,6
nm2, It = 0,423 nA,V = 0.328 V).
Les observations en résolution atomique sur les films 2D et 3D ont montré respectivement les structures 1x1 (figure 3.4a) et Ö3xÖ3 R30° (figure 3.4b) déjà rencontrées sur l'interface Er/Si (111) 7x7 et décrites au chapitre précédent.
A ce stade, aucune modification due à la présence du bore n’apparaît.
Toutefois, des différences ont pu être observées pour des taux de recouvrement dans la gamme de la sous-monocouche.
3.3.3) Le
siliciure métastable 2Ö3x2Ö3 R30°
La figure 3.5
présente la morphologie de l’interface pour un dépôt d’erbium « à
chaud » d’un quart de monocouche d'erbium.
Comme le montre
la figure 3.5a, la surface présente
essentiellement des petits îlots et des zones sombres sur les terrasses. Le
siliciure 2D de type ErSi2 est présent à l’interface mais ne croît
que préférentiellement en bord de marche (signalé par la flèche).


(a) (b)
Figure 3.5 : 0,25 [JM1]monocouche d’erbium déposée « à chaud » (a :200x200 nm2,
b : 35x35 nm2).
Sur la figure 3.5b, on constate que ces zones
sombres se reconstruisent en 2Ö3x2Ö3 R30° et qu’elles ne sont pas situées dans
des trous mais au même niveau que le substrat BÖ3 [17]. Les îlots présentent aussi une périodicité 2Ö3x2Ö3 R30°.
La hauteur entre
ces deux structures 2Ö3 est proche de 3 Å (comme
l'indique le profil de la figure 3.6),
soit une bicouche de silicium : ces deux structures peuvent donc être
considérées comme similaires.

Figure 3.6 : Coupe sur la figure 3.5
(suivant le flèche).
Notons que cette
reconstruction 2Ö3 présente systématiquement
des domaines perturbés alors que cette perturbation n’était pas visible dans le
cas de la 7x7.
Lorsqu’on regarde à
plus petite échelle le bord de la 2Ö3 (figure 3.5b), on remarque la présence d’un anneau de substrat BÖ3 très dopé en bore : cet anneau est dépourvu
de sites brillants. Ceci révèle une diffusion du bore hors de la reconstruction
2Ö3, lors de la nucléation. Concernant la zone
de la figure 3.5b, le nombre
d’atomes de bore ayant diffusé est estimé à 90 soit 20% du nombre d’atomes
contenus dans cette surface 2Ö3. Le nombre important d’atomes restants peut à lui seul expliquer les
perturbations observées dans la structure 2Ö3. On peut aussi remarquer
qu’à 500°C la diffusion de surface des atomes de bore n’est pas nulle.
Il est important de noter que la surface de silicium
recouvert en 2Ö3 est beaucoup plus grande pour
l’interface Er/Si-BÖ3 que pour l’interface
Er/Si(111) 7x7. Ce phénomène ne peut pas être expliqué par la faible réactivité
de la surface BÖ3 par rapport à la surface
7x7 mais plutôt par la présence du bore. Des
transferts de charges, dus au bore, bloquant la diffusion latérale des atomes,
peuvent expliquer cette observation.
Après un recuit
supplémentaire, on constate sur la figure
3.7a la présence de siliciure 2D 1x1 enterré, de forme hexagonale, et
d’îlots triangulaires.


(a)
(b)
Figure 3.7 : (a) interface Er/BÖ3 pour 0,25 monocouche « à chaud »
avec un recuit
supplémentaire à 600°C de 10 min (160x160 nm2).
(b) zoom sur les
îlots triangulaires (40x40 nm2).
Le siliciure 2D semble croître préférentiellement dans les
zones sombres 2Ö3 décrites
précédemment ; cependant, seules des expériences en temps réel avec un STM
à température variable pourraient confirmer cette transformation de zones 2Ö3 en îlots 2D ErSi2.
Le recuit induit
une diffusion des atomes d'erbium contenus dans les îlots 2Ö3 vers les zones sombres. En effet, on
remarque que ces îlots ont disparu au profit du siliciure 2D, ne laissant que
des structures triangulaires évidées (figure
3.7b). La diffusion de l’erbium, due à la température de recuit, entraîne
une augmentation de la densité locale d’atomes d’erbium dans les zones sombres.
Lorsque la concentration locale est suffisante, le siliciure 2D ErSi2
stable se forme. Cette transition de phase traduit le caractère métastable de
la reconstruction 2Ö3.
3.3.4) Les modes de
croissance du siliciure 2D
Pour un dépôt de
0,75 monocouche (figure 3.8),
l’interface laisse apparaître deux structures différentes.

Figure 3.8 : 0,75 monocouche déposée
« à chaud » (200x200 nm2).
Sur cette image, seuls deux siliciures A et B parfaitement
reconstruits 1x1 sont observés avec une différence de hauteur voisine de 3 Å,
soit une bicouche de Si(111) 1x1. Le siliciure B n’est pas un siliciure 3D
puisque les images STM en résolution atomique n’ont pas montré de
reconstruction Ö3xÖ3 R30° mais une 1x1 de bonne qualité (figure 3.4a). Nous sommes plutôt en
présence de deux siliciures de type ErSi2 ayant suivi un mode de
croissance différent. L’un croît directement sur le substrat et l’autre croît
dans le substrat BÖ3 de la même manière que le
siliciure 2D sur 7x7.
Nous proposons sur
la figure 3.9 les modèles atomiques
décrivant ces observations.
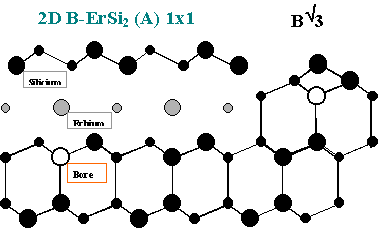

Figure 3.9 : Positions des siliciures A
et B par rapport au substrat BÖ3.
La différence de croissance entre ces siliciures est expliquée
par la densité locale d’atomes de bore. On peut supposer qu'il existe une
densité locale critique en atomes de bore en dessous de laquelle le siliciure
ErSi2 (type A) croît dans le substrat BÖ3. En effet, lorsque la densité locale en
bore est faible, les liaisons pendantes des adatomes ne sont pas passivées par
le bore et la réactivité de surface est augmentée. L’erbium réagit alors de manière importante avec le
substrat en détruisant la BÖ3 pour former le siliciure
sur la couche de Si(111) 1x1, immédiatement en dessous de la BÖ3. Dans le cas où la densité locale de bore
est supérieure à la densité critique, l'interaction Er/BÖ3 est faible et le siliciure ErSi2
(type B) croît préférentiellement sur le substrat initial.
Comme pour l’interface Er/Si(111) 7x7, les siliciures 2D ErSi2
1x1 et 3D ErSi1,7 Ö3xÖ3 R30° ont été observés. On retrouve également un mode de croissance
couche par couche avec une présence plus importante de la structure métastable
2Ö3 dans la gamme de la sous-monocouche. De plus, les images STM mettent
en évidence un siliciure 2D ErSi2 dont la croissance s'initie
directement sur la surface.
3.4 L’INTERFACE
Er/Si(111)-B Ö3xÖ3R30° TRES DOPE
Le but de ce travail étant d’étudier l’influence de la
réactivité de la surface du Si(111) sur la croissance du siliciure d’erbium,
nous avons ensuite utilisé une surface BÖ3 dont la concentration en
bore est maximale. La totalité des liaisons pendantes de la surface BÖ3 est alors passivée. Cette surface est donc
moins réactive que dans l'étude précédente. Les premiers résultats obtenus par
microscopie tunnel ont montré des différences importantes par rapport au
système Er/Si(111) 7x7. Celles-ci ont nécessité des études complètes en
photoémission UV et en spectroscopie ISS, afin de caractériser les nouvelles
propriétés électroniques et la composition des couches formées. Une question
importante concernait la participation du bore dans la formation des siliciures.
Dans une
première partie, nous examinerons l’influence du bore sur la cristallographie
des siliciures. L’influence de la réactivité de surface sur le mode de
croissance sera étudiée dans un deuxième temps.
Dans
l’étude qui suit, l’erbium est déposé sur des substrats BÖ3 de concentration en bore proche d’un tiers
de monocouche (figure 3.2).
3.4.1) Les résultats en photoémission UV et
spectroscopie ISS
La figure
3.10a présente les spectres de photoémission UV (HeI : hn=21,2 eV) aux points ![]() et
et ![]() de la zone de
Brillouin de surface (1x1), pour 1 monocouche d'erbium déposée à 500°C sur la
surface BÖ3 [18]. Ces points dans la zone de Brillouin ont été choisis car la
signature des différentes structures dans les spectres est bien marquée. Notons
qu'à ce stade, une transition Ö3 en 1x1 est observée au DEL
avec un fond diffus important (par rapport à la figure de diffraction DEL de la
BÖ3).
de la zone de
Brillouin de surface (1x1), pour 1 monocouche d'erbium déposée à 500°C sur la
surface BÖ3 [18]. Ces points dans la zone de Brillouin ont été choisis car la
signature des différentes structures dans les spectres est bien marquée. Notons
qu'à ce stade, une transition Ö3 en 1x1 est observée au DEL
avec un fond diffus important (par rapport à la figure de diffraction DEL de la
BÖ3).
A titre de comparaison, la figure 3.10b montre des spectres de photoémission UV dans les mêmes
conditions pour le siliciure 2D ErSi2 fabriqué sur la surface
Si(111) 7x7.
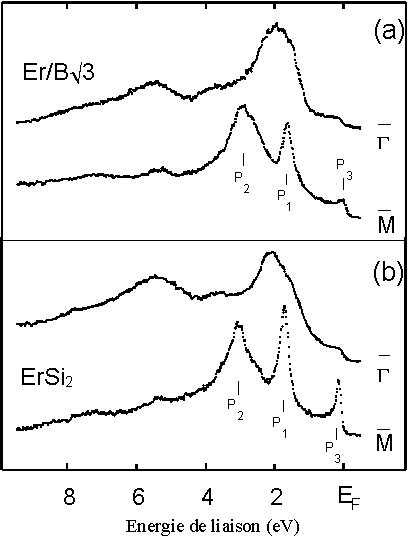
Figure 3.10 : Spectres de photoémission UPS enregistré en ![]() et
et ![]() pour 1 monocouche
pour 1 monocouche
déposée « à chaud » sur les surfaces (a) BÖ3 et (b) 7x7.
L'origine
des structures P1,2,3 a clairement été identifiée dans le cas du
siliciure 2D ErSi2 et les spectres pour l'interface Er/BÖ3 sont extrêmement similaires à ceux du siliciure.
Au point ![]() les pics P1
et P2, respectivement à » 1,7 eV et » 3 eV et provenant des liaisons avant et
arrière du silicium de la première couche, sont situés aux mêmes énergies dans
les deux cas. On remarque aussi un pic P3 proche de EF
pour le siliciure d’erbium ErSi2 nettement moins marqué sur le
spectre de l’interface Er/BÖ3.
les pics P1
et P2, respectivement à » 1,7 eV et » 3 eV et provenant des liaisons avant et
arrière du silicium de la première couche, sont situés aux mêmes énergies dans
les deux cas. On remarque aussi un pic P3 proche de EF
pour le siliciure d’erbium ErSi2 nettement moins marqué sur le
spectre de l’interface Er/BÖ3.
Les fortes
similitudes entre ces spectres suggèrent une structure électronique identique
pour les deux interfaces.
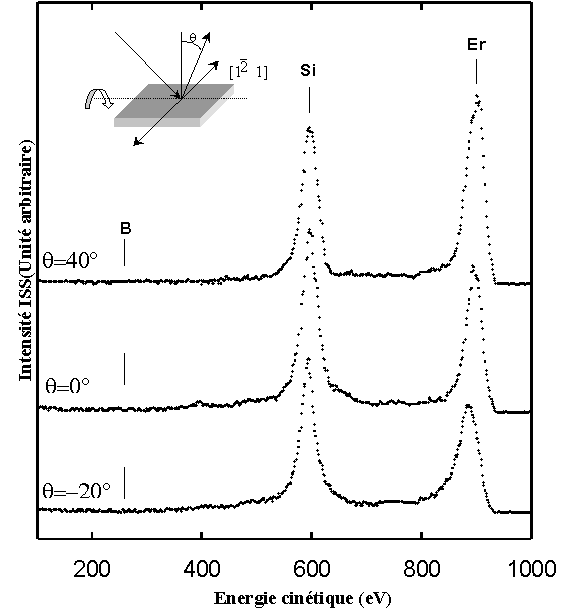
Figure 3.11 : Spectres ISS du siliciure
B-ErSi2 en fonction de l'angle q (E0=1 keV).
Une analyse en spectroscopie ISS va permettre
maintenant de déterminer la composition de la surface ainsi formée.
La figure
3.11 présente des spectres ISS pour plusieurs angles incidents obtenus pour
un dépôt de 1 monocouche d'erbium. Chaque pic est caractéristique d’une espèce
chimique présente à la surface du siliciure. Le siliciure d’erbium étant une
structure ouverte (cf. le §2.3.2 figure
2.4), les deux premières couches atomiques sont sondées.
Les
pics caractéristiques de l’erbium et du silicium sont clairement visibles
tandis que le pic du bore est absent quel que soit l’angle q.
Ces
observations excluent toute présence de bore dans le plan d’erbium et la
bicouche de silicium.
Une étude plus poussée de la structure électronique
est présentée figure 3.12. Elle montre les courbes de dispersions
expérimentales E(![]() ) mesurées dans la direction
) mesurées dans la direction ![]()
![]() de la première zone
de Brillouin de surface 1x1 pour les deux siliciures.
de la première zone
de Brillouin de surface 1x1 pour les deux siliciures.
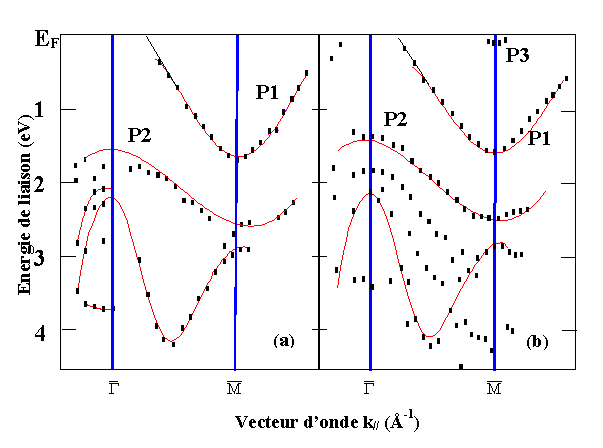
Figure 3.12 : Courbe de dispersion
mesurée sur 1 monocouche d’Er déposée
« à chaud » sur les
surfaces (a) BÖ3 et (b) 7x7 (hn = 21,2 eV).
Les
deux courbes de dispersion sont très semblables et possèdent deux bandes P1
et P2 dont la composition orbitale a été identifiée. La première (P1)
coupe le niveau de Fermi près de ![]() et la deuxième (P2)
est occupée. Elles sont toujours sensiblement parallèles avec un minimum en
et la deuxième (P2)
est occupée. Elles sont toujours sensiblement parallèles avec un minimum en ![]() . Ces observations suggèrent qu’une monocouche d’erbium
déposée sur la surface BÖ3 conduit à la formation
d’un siliciure sensiblement identique au siliciure d’erbium 2D ErSi2
sur 7x7. Ce siliciure 2D sera noté pour la suite B-ErSi2.
Comme cela est décrit dans le chapitre précédent, l’état de surface P1
de caractère Si-pz provient des liaisons pendantes des adatomes de
silicium et l’état P2 des liaisons arrières px, py
de la bicouche du siliciure [19,20].
. Ces observations suggèrent qu’une monocouche d’erbium
déposée sur la surface BÖ3 conduit à la formation
d’un siliciure sensiblement identique au siliciure d’erbium 2D ErSi2
sur 7x7. Ce siliciure 2D sera noté pour la suite B-ErSi2.
Comme cela est décrit dans le chapitre précédent, l’état de surface P1
de caractère Si-pz provient des liaisons pendantes des adatomes de
silicium et l’état P2 des liaisons arrières px, py
de la bicouche du siliciure [19,20].
La structure de bandes du siliciure 2D ErSi2 est caractérisée par une poche de trous en